深圳市富翔科技有限公司
电话:0755-2755 2688
传真:0755-2705 3000
邮箱:pcb@szfux.com
地址:深圳市松岗镇沙埔围创业工业区11栋
网址:www.szfux.com
深圳市富翔科技有限公司
电话:0755-2755 2688
传真:0755-2705 3000
邮箱:pcb@szfux.com
地址:深圳市松岗镇沙埔围创业工业区11栋
网址:www.szfux.com
向更高密度更轻薄发展
近几年来,印刷电路板(以下简称PCB)市场重点从计算机转向通信,这两年更是转向智能手机、平板电脑类移动终端。因此,移动终端用HDI板是PCB增长的主要点。以智能手机为代表的移动终端驱使HDI板更高密度更轻薄。
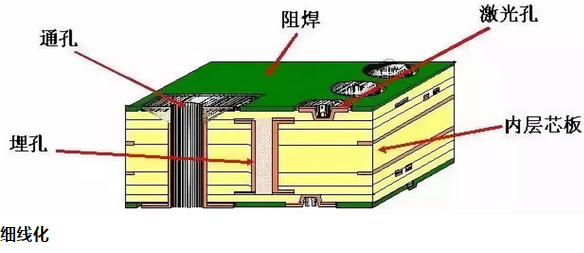
PCB全都向高密度细线化发展,HDI板尤为突出。在十年前HDI板的定义是线宽/线距是0.1 mm/0.1 mm及以下, 现在行业内基本做到60 µm,先进的为40 µm。
PCB线路图形形成,传统的是铜箔基板上光致成像后化学蚀刻工艺(减去法)。这种做法工序多、控制难、成本高。当前精细线路制作趋于半加成法或改进型半加工法。

导体与绝缘基材的结合力,习惯做法是增加表面粗糙度以增加表面积而提高结合力,如强化去玷污处理粗化树脂层表面,用高轮廓铜箔或氧化处理铜面。对于细导线,这种物理方法保证结合力是不行的。于是开发出平滑树脂面上化学镀铜高结合力铜箔,如有“分子接合技术”,是对树脂基材表面化学处理形成一种官能基团能与铜层密切结合。
另外还有细线路制作过程中干膜成像图形转移,铜箔的表面处理是成功的关键因素之一。采用表面清洗剂和微蚀刻剂的最佳组合,以提供一个干净的表面与有足够的面积,促进干膜的附着力。采用化学清洗去掉铜箔的表面抗变色处理层,以及除去污垢与氧化物,依照铜箔的类型选择适当的化学清洁剂,其次是微刻蚀铜箔表面。为使成像干膜与铜层、阻焊图形与细线路结合可靠,也应采取非物理粗化表面的方法。
半加成法积层基材
现在半加成法热点是采用绝缘介质膜积层,从精细线路实现和制作成本看SAP比MSAP更有利。SAP积层用热固化树脂,由激光钻孔后电镀铜形成导通孔和电路图形。目前国际上的HDI积层材料以环氧树脂搭配不同固化剂,以添加无机粉末提高材料刚性及减少CTE,也有使用玻纤布增强刚性。
镀铜填孔
从可靠性考虑,互连孔都采取电镀铜填孔技术,包括盲孔填铜和通孔填铜。
镀铜填孔的能力表现在填实性:被铜封闭的孔中是否存在有空洞;平整性:镀铜孔口存在凹陷(Dimple)程度;厚径比:板厚(孔深)与孔径的比例。
倒芯片封装IC封装载板技术
全球半导体封装中有机基板占到超过三分之一的市场份额。随着手机和平板电脑产量增长, FC-CSP和 FC-PBGA大增。封装载板由有机基板取代陶瓷基板,封装载板的节距越来越小,现在典型的线宽/线距为15 µm。

未来的发展趋势。在BGA和CSP细间距载板会继续下去,同时无芯板与四层或更多层的载板更多应用,路线图显示载板的特征尺寸更小,性能重点要求低介电性、低热膨胀系数和高耐热性,在满足性能目标基础上追求低成本的基板。
适应高频高速化需求
电子通信技术从有线到无线,从低频、低速到高频、高速。现在的手机性能已进入4G并将迈向5G,就是有更快传输速度、更大传输容量。全球云计算时代到来使数据流量成倍增加,通讯设备高频高速化是必然趋势。PCB为适合高频、高速传输的需要,除了电路设计方面减少信号干扰与损耗,保持信号完整性,以及PCB制造保持符合设计要求外,重要的是有高性能基材。
为解决PCB增加速度和信号完整性,主要是针对电信号损失属性。基材选择的关键因素介电常数(Dk)与介质损耗(Df ),当Dk低于4与Df 0.010以下为中Dk/Df级层压板,当Dk低于3.7与Df 0.005以下为低Dk/Df级层压板。
高速PCB中导体铜的表面粗糙度(轮廓)也是影响信号传输损耗的一个重要因素,特别是对10 GHz以上范围的信号。在10 GHz时铜箔粗糙度需要低于1 µm,使用超平面铜箔(表面粗糙度0.04 µm)效果更佳。
伴随着电子设备小型化、高功能,产生高发热,电子设备的热管理要求不断增加,选择的一个解决方案是发展导热性印制电路板。要求PCB有高导热性和耐热性,近十年来一直为此努力。已有高散热性PCB如平面型厚铜基板PCB、铝金属基PCB、铝金属芯双面PCB、铜基平面型PCB、铝基空腔PCB、埋置金属块PCB、可弯曲铝基PCB等。
采用金属基板(IMS)或金属芯印制电路板,起到发热组件的散热作用,比传统的散热器、风扇冷却缩小体积与降低成本。目前金属基板或金属芯多数是金属铝。铝基电路板的优点有简易经济、电子连接可靠、导热和强度高、无焊接无铅环保等,从消费品到汽车、军品和航天都可设计应用。
电子设备的小型化、轻薄化,必然大量使用挠性印制电路板(FPCB)和刚挠结合印制电路板(R-FPCB)。
随着应用面的扩大,除了数量增加也会有许多新的性能要求。聚酰亚胺膜有无色透明、白色、黑色和黄色等不同种类,具有高耐热与低CTE性能,以适合不同场合使用。成本效益佳的聚酯薄膜基板同样有市场,新的性能挑战有高弹性、尺寸稳定性、膜表面品质,以及薄膜的光电耦合性和耐环境性等,以满足最终用户不断变化的要求。
FPCB与刚性HDI板一样要适应高速度和高频率信号传输要求,挠性基材的介电常数和介电损耗必须关注,可利用聚四氟乙烯和先进的聚酰亚胺基板构成挠性电路。在/聚酰亚胺树脂中添加无机粉末和碳纤维填料,可产生一种三层结构的可挠曲导热基板。选用无机填料有氮化铝(AlN)、氧化铝(Al 2O3)和六角形氮化硼(HBN)。
FPCB制造技术方面,在聚酰亚胺(PI)膜上直接金属化制造双面FPCB技术一直在发展,有一种分子接合剂水溶液新技术,并不改变PI膜表面粗糙度而可增加与化学沉铜层结合强度。采用PI膜进行分子接合处理后直接化学镀铜,经过半加成法流程制作双面挠性印制线路板,简化工序及有利环保,对结合力、弯曲性和可靠性等都达到要求 。
还有用印刷自催化电子线路技术,以成卷式生产(R2R),先在PET膜上印刷涂覆具有自催化性的油墨,然后进入化学镀铜槽中,由于油墨具有自催化能力在油墨上沉积铜层,形成铜导体图形,完成PET膜上的金属细线路制作。
FPCB应用市场如智能手机、可穿戴设备、医疗设备、机器人等,对FPCB性能结构提出新要求,开发出FPCB新产品。如超薄挠性多层板,四层FPCB从常规的0.4 mm减薄至约0.2 mm;高速传输挠性板,采用低Dk和低Df聚酰亚胺基材,达到5 Gbps传输速度要求;
大功率挠性板,采用100 µm以上厚导体,以适应高功率大电流电路需要;高散热金属基挠性板是局部使用金属板衬底之R-FPCB;触觉感应性挠性板,由压力传感膜和电极夹在两个聚酰亚胺薄膜之间,组成挠性触觉传感器;可伸缩挠性板或刚挠结合板,其挠性基材为弹性体,金属导线图案的形状改进成为可伸缩。
印制电子历史很早,只是近几年势头兴盛。印制电子技术应用于印制电路产业,是印制电路技术的一部分。
印制电子不断发展可看到商业应用的前景非常广阔,现在已有PCB制造商投入印制电子,他们从挠性板开始,用印制电子电路(PEC)替代印制电路板(PCB)。印制电子技术最接近FPCB,目前基材和油墨材料繁多,一旦性能与成本有突破就会大量应用,降低成本就会开辟更大的市场。
有机和印制电子的混合系统有助于产业的成长。传统的硅和印制电子组件结合的混合系统,这可能开辟了新的PCB产业。这些混合技术包括大面积光刻、网版印刷或喷墨打印,及挠性PCB技术。
印制电子技术的重要一方面是材料,包括基材和功能性油墨。挠性基材除现有FPCB适用外,也开发更高性能基材,目前有陶瓷和高分子树脂混合构成的高介电基板材料,还有高温基材、低温基材和无色透明基材、黄色基材等。
印制电子除使用一些聚合物材料外,还需功能性油墨材料,主要是导电油墨,不断地向提高导电性、印刷适应性、低成本化发展,目前可供印制电子产品选择的导电油墨种类已很多了。另外还有压电、热电、铁电材料,在印制电子中组合使用能发挥多功能性。
印制电子技术的又一重要方面是印刷工艺与相应的印刷设备,这是传统印刷技术的创新发展。印制电子可以应用不同的印刷方法,如凹版印刷、凸版印刷、网版印刷和喷墨打印。网版印刷已在PCB制造中应用,工艺成熟与成本低,目前是向自动化、高精细化发展。
喷墨打印在PCB制造中应用的范围在扩大,从标记符号、阻焊剂到抗蚀图形,进一步直接打印导电图形;同时喷墨打印向图形高精细化和快速化发展。如新的气溶胶喷射技术明显优于压电式喷印,形成导线达到细精与立体化要求,可以在平面或立体构件上直接打印电子电路及元件。
还有喷墨打印同时采用激光照射瞬时固化油墨的方法,导电线路厚度与宽度比1.0以上,如线宽10µm,线高也有10µm,实例有在PI膜上制作线路宽30 µm、线厚20 µm的FPCB。
印制电子目前重点应用是低成本的制造射频识别(RFID)标签,可以成卷印刷完成。潜在的是印刷显示器、照明和有机光伏领域。可穿戴技术市场是当前新兴的一个有利市场。
可穿戴技术各种产品,如智能服装和智能运动眼镜,活动监视器,睡眠传感器,智能表,增强逼真的耳机、导航罗盘等。可穿戴技术设备少不了挠性电子电路,将带动挠性印制电子电路的发展。
埋置元件印制电路板(EDPCB)是实现高密度电子互连的一种产品,埋置元件技术在PCB有很大的潜力。埋置元件PCB制造技术,提高了PCB的功能与价值,除了在通信产品应用外,也在汽车、医疗和工业应用等领域提供了机会。
EDPCB的发展,从碳膏制作的印刷电阻和镍磷合金箔制作的薄膜电阻,以及夹有高介电常数基材构成的平面电容,形成埋置无源元件印制板,到进入埋置IC芯片、埋置贴片元件,形成埋置有源与无源元件印制板。现在面对的课题有埋置元件复杂化及EDPCB的薄型化,以及散热性和热变形控制、最终检测技术等。
元器件埋置技术现在已在手机等便携终端设备中应用。EDPCB制造工艺进入实用的有B2it方法,可以实现高可靠性和低成本;有PALAP方法,达到高层数和低功耗,被用于汽车电子中;有埋置晶圆级封装芯片的通信模块,体现良好的高频特性,今后会有埋置BGA芯片的eWLB出现[19]。随着EDPCB设计规则的确立,这类产品会迅速发展。
PCB表面铜层需要保护,目的是防止铜氧化和变质,在装配时提供连接可靠的表面。PCB制造中一些通常使用的表面涂饰层,有含铅或无铅热风整平焊锡、浸锡、有机可焊性保护膜、化学镀镍/金、电镀镍/金等。
HDI板和IC封装载板的表面涂饰层现从化学镀镍/金(ENIG)发展到化学镀镍/钯/金(ENEPIG),有利于防止元件安装后出现黑盘而影响可靠性。
现有对ENEPIG涂层中钯层作了分析,其中钯层结构有纯钯和钯磷合金,它们有不同的硬度,因此用于打线接合与用于焊接需选择不同的钯层。
经过可靠性影响评估,有微量钯存在会增加铜锡生长厚度;而钯含量过多会产生脆性之钯锡合金,反而使焊点强度下降,因此需有适当钯厚度。
从PCB精细线路的角度来说,表面处理应用化学镀钯/浸金(EPIG)比化学镀镍/镀钯/浸金(ENEPIG)更佳,减少对精细图形线宽/线距的影响。EPIG镀层更薄,不会导致线路变形;EPIG经焊锡试验和引线键合试验能达到要求。
又有新的铜上直接化学镀钯(EP)或直接浸金(DIG),或者铜上化学镀钯与自催化镀金(EPAG)涂层,其优点是适合金线或铜线的打压接合,因没有镍层而有更好高频特性,涂层薄而更适于细线图形,并且减少工序和成本。
PCB最终涂饰层的改进,另外有推出化学镀镍浸银(NiAg)涂层,银有良好导电性、可焊性,镍有抗腐蚀性。有机涂层OSP进行性能改良,提高耐热性和焊接性。还有一种有机与金属复合(OM)涂层,在PCB铜表面涂覆OM涂层有良好的性价比。
“绿色”和“环境友好”现是PCB制造技术进步的重要标志。除了设法采用印制电子和3D打印这类革命性清洁生产技术外,现有PCB制造技术向清洁生产改良是在不断进行。如寻找替代有毒有害物质的材料,减少加工步骤,和减少化学药品的消耗,以及减少水和能源的用量,及材料的可回收利用等。
具体有采用无毒害无机材料作阻燃剂,同时也改善电气性、导热性和热膨胀系数等的无卤素基材;采用激光直接成像减少作业工序和材料消耗;采用半加成法减少电镀铜和蚀刻铜的消耗;采用直接金属化孔工艺,及化学沉铜液中取消有毒有害物质;采用导电膏印刷使导通孔互连加工清洁简便。
直接金属化技术很早就存在,多年的发展趋于成熟。直接金属化工艺有碳黑系和导电聚合物系,用碳或石墨、导电聚合物代替钯活化,化学沉铜液中取消有毒的甲醛、氰化物和难处理的EDTA络合剂。
推出胶体石墨直接孔金属化技术具有稳定的分散性和与多种树脂良好的吸附牲。胶体石墨直接金属化工艺在刚性PCB制造应用多年,现可推行于有复杂的盲孔、埋孔和任意层互连的HDI板、挠性板和刚挠板,可减少工序和设备场地、废水量,有利于环保,并提升生产效率和最终产品的高可靠性[24]。
PCB生产过程中曾经被称为废物甚至是危险废物,现在都不再是“废物”。如多余的铜蚀刻液,微蚀刻处理液、电镀清洗液都趋于在线回收处理。一些新设计的生产线设备,不管是蚀刻线或垂直电镀线与水平电镀线,都考虑了配置在线回收再生装置,还有如分段间气刀合理配置,循环泵的节能,自动分析添加药液延长药液寿命等措施,既有利于提高品质,又有利于节能环保。
印刷电路板的制作非常复杂, 这里以四层印制板为例感受PCB是如何制造出来的。
这里需要一个新的原料叫做半固化片,是芯板与芯板(PCB层数>4),以及芯板与外层铜箔之间的粘合剂,同时也起到绝缘的作用。
下层的铜箔和两层半固化片已经提前通过对位孔和下层的铁板固定好位置,然后将制作好的芯板也放入对位孔中,最后依次将两层半固化片、一层铜箔和一层承压的铝板覆盖到芯板上。
将被铁板夹住的PCB板子们放置到支架上,然后送入真空热压机中进行层压。真空热压机里的高温可以融化半固化片里的环氧树脂,在压力下将芯板们和铜箔们固定在一起。
层压完成后,卸掉压制PCB的上层铁板。然后将承压的铝板拿走,铝板还起到了隔离不同PCB以及保证PCB外层铜箔光滑的责任。这时拿出来的PCB的两面都会被一层光滑的铜箔所覆盖。
要将PCB里4层毫不接触的铜箔连接在一起,首先要钻出上下贯通的穿孔来打通PCB,然后把孔壁金属化来导电。
用X射线钻孔机机器对内层的芯板进行定位,机器会自动找到并且定位芯板上的孔位,然后给PCB打上定位孔,确保接下来钻孔时是从孔位的正中央穿过。
将一层铝板放在打孔机机床上,然后将PCB放在上面。为了提高效率,根据PCB的层数会将1~3个相同的PCB板叠在一起进行穿孔。最后在最上面的PCB上盖上一层铝板,上下两层的铝板是为了当钻头钻进和钻出的时候,不会撕裂PCB上的铜箔。
在之前的层压工序中,融化的环氧树脂被挤压到了PCB外面,所以需要进行切除。靠模铣床根据PCB正确的XY坐标对其外围进行切割。
孔壁的铜化学沉淀
由于几乎所有PCB设计都是用穿孔来进行连接的不同层的线路,一个好的连接需要25微米的铜膜在孔壁上。这种厚度的铜膜需要通过电镀来实现,但是孔壁是由不导电的环氧树脂和玻璃纤维板组成。
所以第一步就是先在孔壁上堆积一层导电物质,通过化学沉积的方式在整个PCB表面,也包括孔壁上形成1微米的铜膜。整个过程比如化学处理和清洗等都是由机器控制的。
固定PCB
清洗PCB
运送PCB
外层PCB布局转移
接下来会将外层的PCB布局转移到铜箔上,过程和之前的内层芯板PCB布局转移原理差不多,都是利用影印的胶片和感光膜将PCB布局转移到铜箔上,唯一的不同是将会采用正片做板。
内层PCB布局转移采用的是减成法,采用的是负片做板。PCB上被固化感光膜覆盖的为线路,清洗掉没固化的感光膜,露出的铜箔被蚀刻后,PCB布局线路被固化的感光膜保护而留下。
外层PCB布局转移采用的是正常法,采用正片做板。PCB上被固化的感光膜覆盖的为非线路区。清洗掉没固化的感光膜后进行电镀。有膜处无法电镀,而没有膜处,先镀上铜后镀上锡。退膜后进行碱性蚀刻,最后再退锡。线路图形因为被锡的保护而留在板上。
将PCB用夹子夹住,将铜电镀上去。之前提到,为了保证孔位有足够好的导电性,孔壁上电镀的铜膜必须要有25微米的厚度,所以整套系统将会由电脑自动控制,保证其精确性。
接下来由一条完整的自动化流水线完成蚀刻的工序。首先将PCB板上被固化的感光膜清洗掉。然后用强碱清洗掉被其覆盖的不需要的铜箔。再用退锡液将PCB布局铜箔上的锡镀层退除。清洗干净后4层PCB布局就完成了。
———— / END / ————
版权说明:本文内容来源电子制造工业技术,版权归原作者所有,转载只为信息知识传播共享,对文中观点本公众号保持中立态度,如有侵权请后台联系小编删除。